在先进半导体制造中,TSV(Through-Silicon Via,硅通孔)工艺对晶圆的减薄与表面抛光有着极高的精度要求。下图展示了某客户的铜/胶复合晶圆在我司设备加工前后的对比情况。
初始状态:晶圆中心相对于背面翘曲约 200μm,表面覆盖铜并镀有胶层,胶层厚度约 85μm,铜层厚度约 150μm。

客户需求:粗糙度(Ra)需 ≤ 10nm,厚度差(TTV)控制在 ±3μm,铜胶高度差 ≤ 1μm。
经过我司高精密磨抛设备的加工,最终结果完全满足并超越了客户需求:
厚度差(TTV):±2μm
表面粗糙度(Ra):≤10nm
铜胶高度差:0.5μm
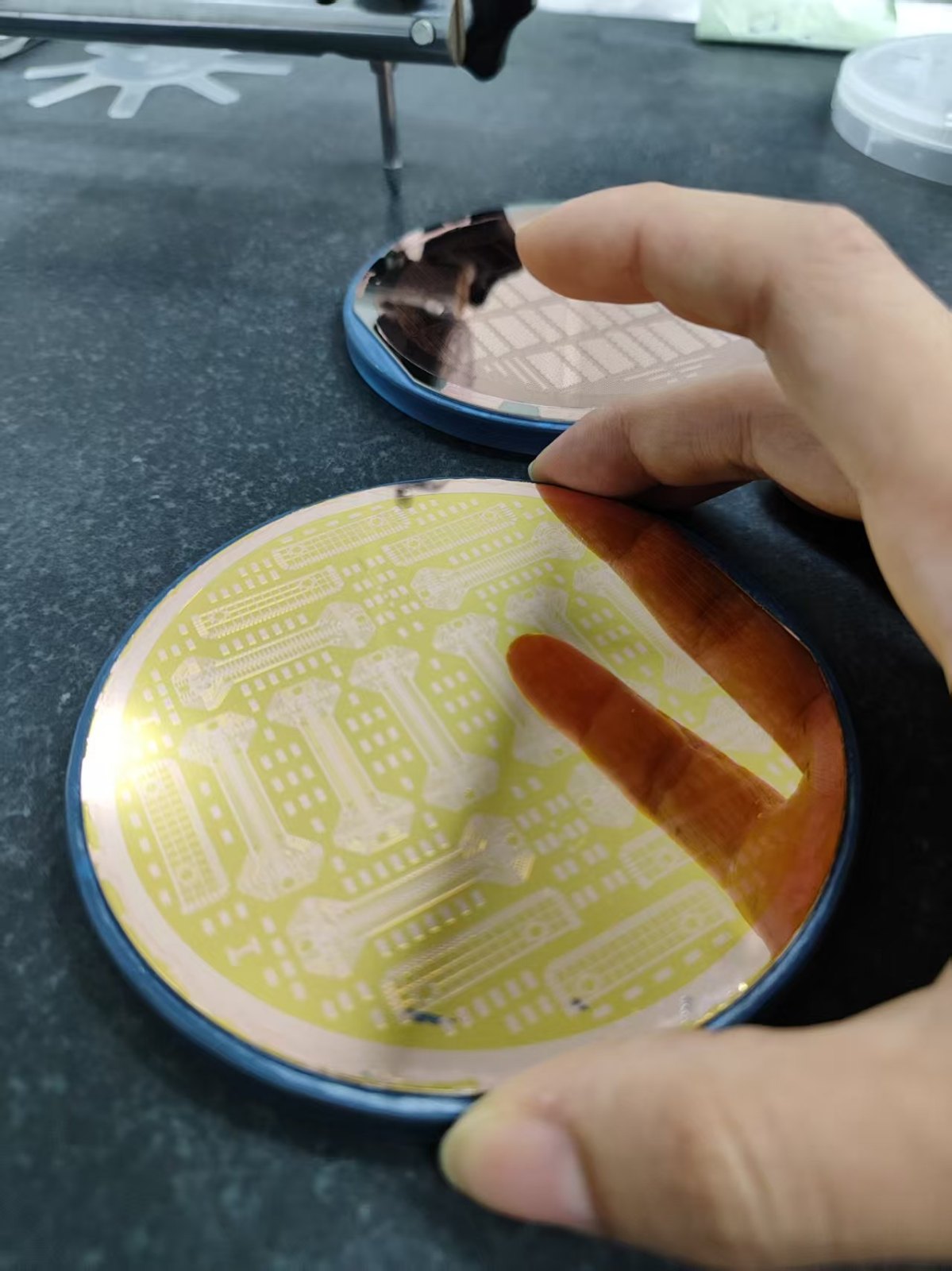
得益于我司高精密磨抛机设备的纳米级表面加工能力与亚微米级厚度控制,晶圆在抛光后表面呈现镜面效果,平整度与一致性显著提升。该工艺不仅确保了 TSV 金属互连的高可靠性,也为后续的先进封装与量产奠定了坚实基础。
凭借对硅片、碳化硅、砷化镓、蓝宝石、玻璃等多种材料的兼容性,我司高精度磨抛设备已广泛应用于半导体、光学、MEMS与先进封装领域,助力客户实现更高良率与更稳定的工艺表现。




























 400-6988-696
400-6988-696 预约咨询
预约咨询